簡介
 MOS電晶體
MOS電晶體雙極性電晶體的輸出特性曲線形狀與MOS器件的輸出特性曲線相似,但線性區與飽和區恰好相反。MOS器件的輸出特性曲線的參變數是VGS,雙極性電晶體的輸出特性曲線的參變數是基極電流IB。衡量溝道長度調製的大小可以用厄萊(Early)電壓VA表示,它反映了飽和區輸出電流曲線上翹的程度。
結構
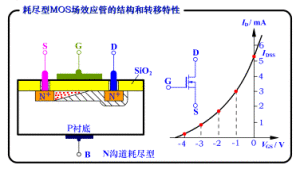 MOS電晶體基本結構
MOS電晶體基本結構NMOS和PMOS在結構上完全相像,所不同的是襯底和源漏的摻雜類型。簡單地說,NMOS是在P型矽的襯底上,通過選擇摻雜形成N型的摻雜區,作為NMOS的源漏區;PMOS是在N型矽的襯底上,通過選擇摻雜形成P型的摻雜區,作為PMOS的源漏區。如圖所示,兩塊源漏摻雜區之間的距離稱為溝道長度L,而垂直於溝道長度的有效源漏區尺寸稱為溝道寬度W。對於這種簡單的結構,器件源漏是完全對稱的,只有在套用中根據源漏電流的流向才能最後確認具體的源和漏。
器件的柵電極是具有一定電阻率的多晶矽材料,這也是矽柵MOS器件的命名根據。在多晶矽柵與襯底之間是一層很薄的優質二氧化矽,它是絕緣介質,用於絕緣兩個導電層:多晶矽柵和矽襯底,從結構上看,多晶矽柵-二氧化矽介質-摻雜矽襯底(Poly-Si--SiO2--Si)形成了一個典型的平板電容器,通過對柵電極施加一定極性的電荷,就必然地在矽襯底上感應等量的異種電荷。這樣的平板電容器的電荷作用方式正是MOS器件工作的基礎。
模型
MOS管的等效電路模型及寄生參數如圖2所示。圖2中各部分的物理意義為:
(2)C1代表從柵極到源端N+間的電容,它的值是由結構所固定的。
(3)C2+C4代表從柵極到源極P區間的電容。C2是電介質電容,共值是固定的。而C4是由源極到漏極的耗盡區的大小決定,並隨柵極電壓的大小而改變。當柵極電壓從0升到開啟電壓UGS(th)時,C4使整個柵源電容增加10%~15%。
(4)C3+C5是由一個固定大小的電介質電容和一個可變電容構成,當漏極電壓改變極性時,其可變電容值變得相當大。
(5)C6是隨漏極電壓變換的漏源電容。
MOS管輸入電容(Ciss)、跨接電容(CRSS)、輸出電容(Coss)和柵源電容、柵漏電容、漏源電容間的關係如下:
工作特點
 MOS電晶體
MOS電晶體以SiO2為柵介質時,叫MOS器件,這是最常使用的器件形式。歷史上也出現過以Al2O3為柵介質的MAS器件和以 Si3N4為柵介質的MNS器件,以及以SiO2+Si3N4為柵介質的MNOS器件,統稱為金屬-絕緣柵-半導體器件--MIS 器件。
以Al為柵電極時,稱鋁柵器件。以重摻雜多晶矽(Poly-Si) 為柵電極時, 稱矽柵器件。它是當前MOS器件的主流器件。 矽柵工藝是利用重摻雜的多晶矽來代替鋁做為MOS管的柵電極,使MOS電路特性得到很大改善,它使|VTP|下降1.1V,也容易獲得合適的VTN值並能提高開關速度和集成度。
矽柵工藝具有自對準作用,這是由於矽具有耐高溫的性質。柵電極,更確切的說是在柵電極下面的介質層,是限定源、漏擴散區邊界的擴散掩膜,使柵區與源、漏交迭的密勒電容大大減小,也使其它寄生電容減小,使器件的頻率特性得到提高。另外,在源、漏擴散之前進行柵氧化,也意味著可得到淺結。
鋁柵工藝為了保證柵金屬與漏極鋁引線之間有一定的間隔,要求漏擴散區面積要大些。而在矽柵工藝中覆蓋源漏極的鋁引線可重迭到柵區,這是因為有一絕緣層將柵區與源漏電極引線隔開,從而可使結面積減少30%~40%。
矽柵工藝還可提高集成度,這不僅是因為擴散自對準作用可使單元面積大為縮小,而且因為矽柵工藝可以使用“二層半布線”即一層鋁布線,一層重摻雜多晶矽布線,一層重摻雜的擴散層布線。由於在製作擴散層時,多晶矽要起掩膜作用,所以擴散層不能與多晶矽層交叉,故稱為兩層半布線.鋁柵工藝只有兩層布線:一層鋁布線,一層擴散層布線。矽柵工藝由於有兩層半布線,既可使晶片面積比鋁柵縮小50%又可增加布線靈活性。
當然,矽柵工藝較之鋁柵工藝複雜得多,需增加多晶矽澱積、等離子刻蝕工序,而且由於表面層次多,台階比較高,表面斷鋁,增加了光刻的困難,所以又發展了以Si3N4作掩膜的局部氧化LOCOS--Local oxidation on silicon (又稱為 MOSIC 的局部氧化隔離工藝Local Oxidation Isolation for MOSIC) ,或稱等平面矽柵工藝。
擴散條連線由於其電容較大,漏電流也較大,所以儘量少用,一般是將相應管子的源或漏區加以延伸而成。擴散條也用於短連線,注意擴散條不能跨越多晶矽層,有時把這層連線稱為“半層布線”。因硼擴散薄層電阻為30~120Ω/□,比磷擴散的R□大得多,所以硼擴散連線引入的分布電阻更為可觀,擴散連線的寄生電阻將影響輸出電平是否合乎規範值,同時也因加大了充放電的串聯電阻而使工作速度下降。因此,在CMOS電路中,當使用硼擴散條做連線用時要考慮到這一點。
當在NMOS的柵上施加相對於源的正電壓VGS時,柵上的正電荷在P型襯底上感應出等量的負電荷,隨著VGS的增加,襯底中接近矽-二氧化矽界面的表面處的負電荷也越多。其變化過程如下:當VGS比較小時,柵上的正電荷還不能使矽-二氧化矽界面處積累可運動的電子電荷,這是因為襯底是P型的半導體材料,其中的多數載流子是正電荷空穴,柵上的正電荷首先是驅趕表面的空穴,使表面正電荷耗盡,形成帶固定負電荷的耗盡層。
這時,雖然有VDS的存在,但因為沒有可運動的電子,所以,並沒有明顯的源漏電流出現。增加VGS,耗盡層向襯底下部延伸,並有少量的電子被吸引到表面,形成可運動的電子電荷,隨著VGS的增加,表面積累的可運動電子數量越來越多。這時的襯底負電荷由兩部分組成:表面的電子電荷與耗盡層中的固定負電荷。如果不考慮二氧化矽層中的電荷影響,這兩部分負電荷的數量之和等於柵上的正電荷的數量。當電子積累達到一定水平時,表面處的半導體中的多數載流子變成了電子,即相對於原來的P型半導體,具有了N型半導體的導電性質,這種情況稱為表面反型。
根據電晶體理論,當NMOS電晶體表面達到強反型時所對應的VGS值,稱為NMOS電晶體的閾值電壓VTN (Threshold voltage for N-channel transistor)。這時,器件的結構發生了變化,自左向右,從原先的 n+-p-n+結構,變成了n+-n-n+結構,表面反型的區域被稱為溝道區。在VDS的作用下,N型源區的電子經過溝道區到達漏區,形成由漏流向源的漏源電流。顯然,VGS的數值越大,表面處的電子密度越大,相對的溝道電阻越小,在同樣的VDS的作用下,漏源電流越大。
當VGS大於VTN,且一定時,隨著VDS的增加,NMOS的溝道區的形狀將逐漸的發生變化。在VDS較小時,溝道區基本上是一個平行於表面的矩形,當VDS增大後,相對於源端的電壓VGS和VDS在漏端的差值VGD逐漸減小,並且因此導致漏端的溝道區變薄,當達到VDS=VGS-VTN時,在漏端形成了VGD=VGS-VDS=VTN的臨界狀態,這一點被稱為溝道夾斷點,器件的溝道區變成了楔形,最薄的點位於漏端,而源端仍維持原先的溝道厚度。器件處於VDS=VGS-VTN的工作點被稱為臨界飽和點。
在逐漸接近臨界狀態時,隨著VDS的增加,電流的變化偏離線性,NMOS電晶體的電流-電壓特性發生彎曲。在臨界飽和點之前的工作區域稱為非飽和區,顯然,線性區是非飽和區中VDS很小時的一段。繼續在一定的VGS條件下增加VDS (VDS>VGS-VTN),在漏端的導電溝道消失,只留下耗盡層,溝道夾斷點向源端趨近。由於耗盡層電阻遠大於溝道電阻,所以這種向源端的趨近實際上位移值∆L很小,漏源電壓中大於VGS-VTN的部分落在很小的一段由耗盡層構成的區域上,有效溝道區內的電阻基本上維持臨界時的數值。因此,再增加源漏電壓VDS,電流幾乎不增加,而是趨於飽和。這時的工作區稱為飽和區。NMOS電晶體的電流—電壓特性曲線如圖3所示。
事實上,由於∆L的存在,實際的溝道長度L將變短,對於L比較大的器件,∆L/L比較小,對器件的性能影響不大,但是,對於短溝道器件,這個比值將變大,對器件的特性產生影響。器件的電流-電壓特性在飽和區將不再是水平直線的性狀,而是向上傾斜,也就是說,工作在飽和區的NMOS器件的電流將隨著VDS的增加而增加。這種在VDS作用下溝道長度的變化引起飽和區輸出電流變化的效應,被稱為溝道長度調製效應。衡量溝道長度調製的大小可以用厄萊(Early)電壓VA表示,它反映了飽和區輸出電流曲線上翹的程度。
雙極性電晶體的輸出特性曲線形狀與MOS器件的輸出特性曲線相似,但線性區與飽和區恰好相反。MOS器件的輸出特性曲線的參變數是VGS ,雙極性電晶體的輸出特性曲線的參變數是基極電流IB。衡量溝道長度調製的大小可以用厄萊(Early)電壓VA表示,它反映了飽和區輸出電流曲線上翹的程度。
 MOS電晶體
MOS電晶體NMOS一樣,導通的PMOS的工作區域也分為非飽和區,臨界飽和點和飽和區。當然,不論NMOS還是PMOS,當未形成反型溝道時,都處於截止區,其電壓條件是:VGSVTP (PMOS),值得注意的是,PMOS的VGS和VTP都是負值。
以上的討論,都有一個前提條件,即當VGS=0時沒有導電溝道,只有當施加在柵上的電壓絕對值大於器件的閾值電壓的絕對值時,器件才開始導通,在漏源電壓的作用下,才能形成漏源電流。以這種方式工作的MOS器件被稱為增強型(enhancement mode),又稱常關閉型(normally-off) MOS電晶體。所以,上面介紹的是增強型NMOS電晶體和增強型PMOS電晶體。
除了增強型MOS器件外,還有一類MOS器件,它們在柵上的電壓值為零時(VGS=0),在襯底上表面就已經形成了導電溝道,在VDS的作用下就能形成漏源電流。這類MOS器件被稱為耗盡型(depletion mode),又稱常開啟型(normally-on) MOS電晶體。
耗盡型MOS電晶體分為耗盡型NMOS電晶體和耗盡型PMOS電晶體。對於耗盡型器件,由於VGS=0時就存在導電溝道,因此,要關閉溝道將施加相對於同種溝道增強型MOS管的反極性電壓。對耗盡型NMOS電晶體,由於在VGS=0時器件的表面已經積累了較多的電子,因此,必須在柵極上施加負電壓,才能將表面的電子“趕走”。同樣地,對耗盡型PMOS電晶體,由於在VGS=0時器件的表面已經存在積累的正電荷空穴,因此,必須在柵極上施加正電壓,才能使表面導電溝道消失。
使耗盡型器件的表面溝道消失所必須施加的電壓,稱為夾斷電壓 VP (pinch-off),顯然,NMOS的夾斷電壓VPN0。耗盡型NMOS電晶體夾斷電壓VP的符號為負。增強型NMOS電晶體閾值電壓VT的符號為正。
耗盡型器件的初始導電溝道的形成主要來自兩個方面:
①柵與襯底之間的二氧化矽介質中含有的固定電荷的感應;
②通過工藝的方法在器件襯底的表面形成一層反型材料。顯然,前者較後者具有不確定性,二氧化矽中的固定正電荷是在二氧化矽形成工藝中或後期加工中引入的,通常是不希望存在的。後者則是為了獲得耗盡型MOS電晶體而專門進行的工藝加工,通常採用離子注入的方式在器件的表面形成與襯底摻雜類型相反(與源漏摻雜類型相同)的區域,例如,為獲得耗盡型NMOS管,在P型襯底表面通過離子注入方式注入Ⅴ價元素磷或砷,形成N型的摻雜區作為溝道。由於離子注入可以精確的控制摻雜濃度,因此器件的夾斷電壓值具有可控性。
綜上所述,MOS電晶體具有四種基本類型:增強型NMOS電晶體,耗盡型NMOS電晶體,增強型PMOS電晶體,耗盡型PMOS電晶體。在實際的邏輯電路套用中,一般不使用耗盡型PMOS電晶體。
開通過程
 MOS電晶體
MOS電晶體圖6是存儲電荷高或低的兩種二極體電流、電壓波形。從圖中可以看出存儲電荷少時,反向電壓的斜率大,並且會產生有害的振動。而前置電流低則存儲電荷少,即在空載或輕載時是最壞條件。所以進行最佳化驅動電路設計時應著重考慮前置電流低的情況,即空載或輕載的情況,應使這時二極體產生的振動在可接受範圍內。
最高工作頻率
MOS電晶體的最高工作頻率被定義為:當對柵極輸入電容CGC的充放電電流和漏源交流電流的數值相等時,所對應的工作頻率為MOS電晶體的最高工作頻率。這是因為當柵源間輸入交流信號時,由源極增加(減少)流入的電子流,一部分通過溝道對電容充(放)電,一部分經過溝道流向漏極,形成漏源電流的增量。因此,當變化的電流全部用於對溝道電容充放電時,電晶體也就失去了放大能力。
跨導gm
MOS電晶體的跨導gm表示交流小信號時衡量MOS器件VGS對IDS的控制能力(VDS恆定)的參數,也是MOS電晶體的一個極為重要的參數。 (忽略溝道長度調製效應,λ=0,在以下分析中,如未出現λ參數,均表示λ=0的情況)。
閾值電壓
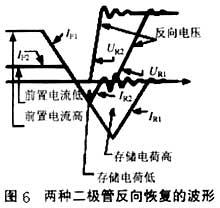 MOS電晶體
MOS電晶體Bakegate的摻雜是決定閾值電壓的主要因素。如果backgate越重摻雜,它就越難反轉。要反轉就要更強的電場,閾值電壓就上升了。MOS管的backgate摻雜能通過在gate dielectric表面下的稍微的implant來調整。這種implant被叫做閾值調整implant(或Vt調整implant)。
考慮一下Vt調整implant對NMOS管的影響。如果implant是由acceptors組成的,那么矽表面就更難反轉,閾值電壓也升高了。如果implant是由donors組成的,那么矽表面更容易反轉,閾值電壓下降。如果注入的donors夠多,矽表面實際上就反向摻雜了。這樣,在零偏置下就有了一薄層N型矽來形成永久的channel。隨著GATE偏置電壓的上升,channel變得越來越強的反轉。隨著GATE偏置電壓的下降,channel變的越來越弱,最後消失了。這種NMOS管的閾值電壓實際上是負的。這樣的電晶體稱為耗盡模式NMOS,或簡單的叫做耗盡型NMOS。相反,一個有正閾值電壓的的NMOS叫做增強模式NMOS,或增強型NMOS。絕大多數商業化生產的MOS管是增強型器件,但也有一些套用場合需要耗盡型器件。耗盡型PMOS也能被生產出來。這樣的器件的閾值電壓是正的。
耗盡型的器件應該儘量的被明確的標識出來。不能靠閾值電壓的正負符號來判斷,因為通常許多工程師忽略閾值電壓的極性。因此,應該說“閾值電壓為0.7V的耗盡型PMOS”而不是閾值電壓為0.7V的PMOS。很多工程師會把後者解釋為閾值電壓為-0.7V的增強型PMOS而不是閾值電壓為+0.7V的耗盡型PMOS。明白無誤的指出是耗盡型器件可以省掉很多誤會的可能性。
為了區別不同的MOS管有很多特殊的符號。圖7就是這些符號。(符號A,B,E,F,G,和H被許多不同的作者使用)符號A和B分別是NMOS和PMOS管的標準符號。這些符號在工業界沒有被普遍使用;相反,符號C和D分別代表NMOS和PMOS。這些符號被設計的很像NPN和PNP管。這么做能突出MOS和雙極型電路之間基本的相似點。符號E和F用在backgates接到已知電位上時。每個MOS管都有一個backgate,所以它總得接到什麼地方。符號E和F可能有點讓人看不懂,因為讀者必須自己推斷bakgate的接法。儘管如此,這些符號還是非常流行,因為他們使電路同看上去更易讀。符號G和H經常被用在耗盡型器件上,符號中從drain到source的粗線就表示了零偏置時的channel。符號I和J表示高電位drain的非對稱電晶體,符號K和L表示drain和source都是高電位的對稱電晶體。除了這些,MOS管還有其他很多電路符號;圖1.24僅僅是其中的一小部分。
電介質在決定閾值電壓方面也起了重要作用。厚電介質由於比較厚而削弱了電場。所以厚電介質使閾值電壓上升,而薄電介質使閾值電壓下降。理論上,電介質成分也會影響電場強度。而實際上,幾乎所有的MOS管都用純二氧化矽作為gate dielectric。這種物質可以以極純的純度和均勻性生長成非常薄的薄膜;其他物質跟它都不能相提並論。因此其他電介質物質只有很少的套用。(也有用高介電常數的物質比如氮化矽作為gate dielectric的器件。有些作者把所有的MOS類電晶體,包括非氧化物電介質,稱為insulated-gate field effect transistor(IGFET))
gate的物質成分對閾值電壓也有所影響。如上所述,當GATE和BACKGATE短接時,電場就出現在gate oxide上。這主要是因為GATE和BACKGATE物質之間的work function差值造成的。大多數實際套用的電晶體都用重摻雜的多晶矽作為gate極。改變多晶矽的摻雜程度就能控制它的work function。
GATE OXIDE或氧化物和矽表面之間界面上過剩的電荷也可能影響閾值電壓。這些電荷中可能有離子化的雜質原子,捕獲的載流子,或結構缺陷。電介質或它表面捕獲的電荷會影響電場並進一步影響閾值電壓。如果被捕獲的電子隨著時間,溫度或偏置電壓而變化,那么閾值電壓也會跟著變化。
影響因素
 MOS電晶體
MOS電晶體第二個影響閾值電壓的因素是襯底的摻雜濃度。從前面的分析可知,要在襯底的上表面產生反型層,必須施加能夠將表面耗盡並且形成襯底少數載流子的積累的柵源電壓,這個電壓的大小與襯底的摻雜濃度有直接的關係。襯底摻雜濃度(QB)越低,多數載流子的濃度也越低,使襯底表面耗盡和反型所需要的電壓VGS越小。
所以,襯底摻雜濃度是一個重要的參數,襯底摻雜濃度越低,器件的閾值電壓數值將越小,反之則閾值電壓值越高。對於一個成熟穩定的工藝和器件基本結構,器件閾值電壓的調整,主要通過改變襯底摻雜濃度或襯底表面摻雜濃度進行。襯底表面摻雜濃度的調整是通過離子注入雜質離子進行。
第三個影響閾值電壓的因素是由柵氧化層厚度tOX決定的單位面積柵電容的大小。單位面積柵電容越大,電荷數量變化對VGS的變化越敏感,器件的閾值電壓則越小。
實際的效應是,柵氧化層的厚度越薄,單位面積柵電容越大,相應的閾值電壓數值越低。但因為柵氧化層越薄,氧化層中的場強越大,因此,柵氧化層的厚度受到氧化層擊穿電壓的限制。選用其他介質材料做柵介質是當前工藝中的一個方向。例如選用氮氧化矽 SiNxOy 替代二氧化矽是一個微電子技術的發展方向。正在研究其它具有高介電常數的材料,稱為高k柵絕緣介質。
第四個對器件閾值電壓具有重要影響的參數是柵材料與矽襯底的功函式差ΦMS的數值,這和柵材料性質以及襯底的摻雜類型有關,在一定的襯底摻雜條件下,柵極材料類型和柵極摻雜條件都將改變閾值電壓。對於以多晶矽為柵極的器件,器件的閾值電壓因多晶矽的摻雜類型以及摻雜濃度而發生變化。
可見,在正常條件下,很容易得到增強型PMOS管。為了製得增強型NMOS管,則需注意減少Qss、Qox,增加QB。採用矽柵工藝對製做增強型NMOS管和絕對值小的增強型PMOS管有利。
轉移特性
將MOS電晶體的柵漏連線,因為VGS=VDS,所以,VDS>VGS-VTN, 導通的器件一定工作在飽和區。這時,電晶體的電流-電壓特性應遵循飽和區的薩氏方程:
IDS=KN/2•W/L•(VGS-VTN)2(1+λVDS)
即平方律關係。4種MOS電晶體的平方律轉移特性如圖所示,這樣的連線方式在許多設計中被採用。
襯底偏置效應
 MOS電晶體
MOS電晶體γ為襯底偏置效應係數,它隨襯底摻雜濃度而變化,典型值:NMOS電晶體,γ=0.7~3.0。PMOS電晶體,γ=0.5~0.7對於PMOS電晶體,∆VT取負值,對NMOS電晶體,取正值。
對處於動態工作的器件而言,當襯底接一固定電位時,襯偏電壓將隨著源節點電位的變化而變化,產生對器件溝道電流的調製,這稱為背柵調製,用背柵跨導gmB來定義這種調製作用的大小:
其中三個重要連線埠參數:gm、gds和gmb對應了MOS器件的三個信號連線埠G-S、D-S、B-S,它們反映了連線埠信號對漏源電流的控制作用。

