 顆粒封裝
顆粒封裝發展歷程
隨著光電、微電製造工藝技術的飛速發展,電子產品始終在朝著更小、更輕、更便宜的方向發展,因此晶片元件的封裝形式也
 顆粒封裝
顆粒封裝DIP封裝
上個世紀的70年代,晶片封裝基本都採用DIP(Dualln-linePackage,雙列直插式封裝)封裝,此封裝形式在當時具有適合PCB(印刷電路板)穿孔安裝,布線和操作較為方便等特點。DIP封裝的結構形式多種多樣,包括多層陶瓷雙列直插式DIP,單層陶瓷雙列直插式DIP,引線框架式DIP等。但DIP封裝形式封裝效率是很低的,其晶片面積和封裝面積之比為1:1.86,這樣封裝產品的面積較大,記憶體條PCB板的面積是固定的,封裝面積越大在記憶體上安裝晶片的數量就越少,記憶體條容量也就越小。同時較大的封
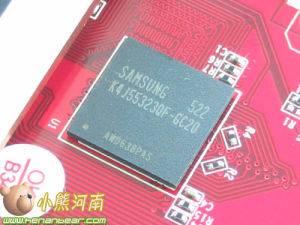 顆粒封裝
顆粒封裝TSOP封裝
到了上個世紀80年代,記憶體第二代的封裝技術TSOP出現,得到了業界廣泛的認可,時至今日仍舊是記憶體封裝的主流技術。TSOP是“ThinSmallOutlinePackage”的縮寫,意思是薄型小尺寸封裝。TSOP記憶體是在晶片的周圍做出引腳,採用SMT技術(表面安裝技術)直接附著在PCB板的表面。TSOP封裝外形尺寸時,寄生參數(電流大幅度變化時,引起輸出電壓擾動)減小,適合高頻套用,操作比較方便,可靠性也比較高。同時TSOP封裝具有成
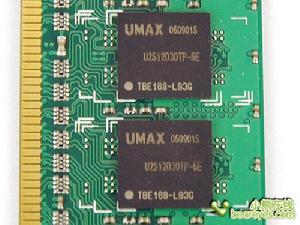 顆粒封裝
顆粒封裝BGA封裝
20世紀90年代隨著技術的進步,晶片集成度不斷提高,I/O引腳數急劇增加,功耗也隨之增大,對積體電路封裝的要求也更加嚴格。為了滿足發展的需要,BGA封裝開始被套用於生產。BGA是英文BallGridArrayPackage的縮寫,即球柵陣列封裝。
採用BGA技術封裝的記憶體,可以使記憶體在體積不變的情況下記憶體容量提高兩到三倍,BGA與TSOP相比,具有更小的體積,更好的散熱性能和電性能。BGA封裝技術使每平方英寸的存儲量有了很大提升,採用BGA封裝技術的記憶體產品在相同容量下,體積只有TSOP封裝的三分之一;另外,與傳統TSOP封裝方式相比,BGA封裝方式有更加快速和有效的散熱途徑。
BGA封裝的I/O端子以圓形或柱狀焊點按陣列形式分布在封
 顆粒封裝
顆粒封裝說到BGA封裝就不能不提Kingmax公司的專利TinyBGA技術,TinyBGA英文全稱為TinyBallGridArray(小型球柵陣列封裝),屬於是BGA封裝技術的一個分支,是Kingmax公司於1998年8月開發成功的,其晶片面積與封裝面積之比不小於1:1.14,可以使記憶體在體積不變的情況下記憶體容量提高2~3倍,與TSOP封裝產品相比,其具有更小的體積、更好的散熱性能和電性能。
採用TinyBGA封裝技術
 顆粒封裝
顆粒封裝TinyBGA封裝的記憶體其厚度也更薄(封裝高度小於0.8mm),從金屬基板到散熱體的有效散熱路徑僅有0.36mm。因此,TinyBGA記憶體擁有更高的熱傳導效率,非常適用於長時間運行的系統,穩定性極佳。
CSP封裝
CSP(ChipScalePackage),是晶片級封裝的意思。CS
 顆粒封裝
顆粒封裝CSP封裝記憶體晶片的中心引腳形式有效地縮短了信號的傳導距離,其衰減隨之減少,晶片的抗干擾、抗噪性能也能得到大幅提升,這也使得CSP的存取時間比BGA改善15%-20%。在CSP的封裝方式中,記憶體顆粒是通過一個個錫球焊接在PCB板上,由於焊點和PCB板的接觸面積較大,所以記憶體晶片在運行中所產生的熱量可以很容易地傳導到PCB板上並散
 顆粒封裝
顆粒封裝WLCSP(Wafer Level Chip Scale Package晶圓級晶片封裝),這種技術不同於傳統的先切割晶圓,再封裝測試的做法,而是先在整片晶圓上進行封裝和測試,然後再切割。WLCSP有著更明顯的優勢。首先是工藝工序大大最佳化,晶圓直接進入封裝工序,而傳統工藝在封裝之前還要對晶圓進行切割、分類。所有積體電路一次封裝,刻印工作直接在晶圓上進行,設備測試一次完成,這在傳統工藝中都是不可想像的。其次,生產周期和成本大幅下降,WLCSP的生產周期已經縮短到1天半。而且,新工藝帶來優異的性能,採用WLCSP封裝技術使晶片所需針腳數減少,提高了集成度。WLCSP帶來的另一優點是電氣性能的提升,引腳產生的電磁干擾幾乎被消除。採用WLCSP封裝的記憶體可以支持到800MHz的頻率,最大容量可達1GB!
優點和缺點
 顆粒封裝
顆粒封裝TSOP是記憶體顆粒通過引腳(圖2黃色框)焊接在記憶體PCB上的,引腳由顆粒向四周引出,所以肉眼可以看到顆粒與記憶體PCB接口處有很多金屬柱狀觸點,並且顆粒封裝的外形尺寸較大,呈長方形,其優點是成本低、工藝要求不高,但焊點和PCB的接觸面積較小,使
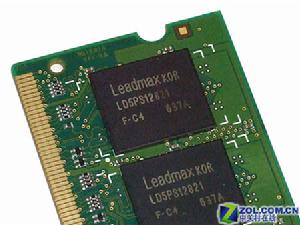 顆粒封裝
顆粒封裝速度與容量:成倍提升
選擇記憶體和CPU搭配的時候就是看記憶體頻寬是否大於或者等於CPU的頻寬,這樣才可以滿足CPU的數據傳輸要求。從頻寬公式(頻寬=位寬×頻率÷8)可以得知,和頻寬關係最緊密的就是頻率。這也是為什麼三代記憶體等效頻率一升再升的原因之一,其目的就是為了滿足CPU的頻寬。
不僅速度上有所提升,而且隨著我們套用的提高,我們也需要更大容量的單根記憶體,DDR時代賣得最火的是512MB和1GB的記憶體,而到了DDR2時代,兩根1GB記憶體就只
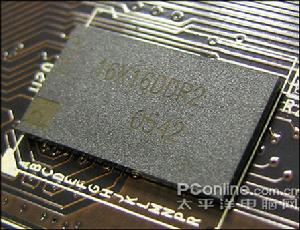 顆粒封裝
顆粒封裝延遲值:一代比一代高
任何記憶體都有一個CAS延遲值,這就好像甲命令乙做事情,乙需要思考的時間一樣。一般而言,記憶體的延遲值越小,傳輸速度越快。從DDR、DDR2、DDR3記憶體身上看到,雖然它們的傳輸速度越來越快,頻率越來越高,容量也越來越大,但延遲值卻提高了,譬如DDR記憶體的延遲值(第一位數值大小最重要,普通用戶關注第一位延遲值就可以了)為1.5、2、2.5、3;而到了DDR2時代,延遲值提升到了3、4、5、6;到了DDR3時代,延遲值也繼續提升到了5、6、7、8或更高。
功耗:一次又一次降低
 顆粒封裝
顆粒封裝製造工藝:不斷提高
從DDR到DDR2再到DDR3記憶體,其製造工藝都在不斷改善,更高的工藝水平會使記憶體電氣性能更好,成本更低。譬如DDR記憶體顆粒廣泛採用0.13微米製造工藝,而DDR2顆粒採用了0.09微米製造工藝,DDR3顆粒則採用了全新65nm製造工藝(1微米=1000納米)。
計算機術語
| 21世紀是網路和信息化的世紀,電腦的發展改變著人們的生活。通過了解計算機術語,能更清楚的認識計算機,更好的運用計算機。 |

