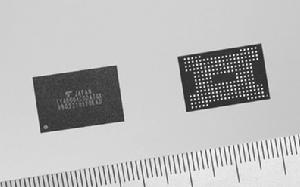 MCP存儲器
MCP存儲器多晶片封裝(MCP)技術可以將FLASH、DRAM等不同規格的晶片利用系統封裝方式整合成單一晶片,生產時間短、製造成本低,且具低功耗、高數據傳輸速率等優勢,已經是攜帶型電子產品內置記憶體產品最主要的規格。另外,數位電視、機頂盒、網路通信產品等也已經開始採用各式MCP產品。
套用發展
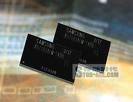 MCP存儲器
MCP存儲器手機器件的典型劃分方式包括數字基帶處理器、模擬基帶、存儲器、射頻和電源晶片。掉電數據不丟失的非易失性快閃記憶體以其電擦除、微功耗、大容量、小體積的優勢,在手機存儲器中獲得廣泛套用。每種手機都強調擁有不同於其他型號的功能,這就使它需要某種特定的存儲器。日趨流行的多功能高端手機需要更大容量、更多類型高速存儲器子系統的支撐。
封裝集成有靜態隨機存取存儲器(SRAM)和快閃記憶體的MCP,就是為適應2.5G、3G高端手機存儲器的低功耗、高密度容量套用要求而率先發展起來的,也是快閃記憶體實現各種創新的積木塊。 國際市場上,手機存儲器MCP的出貨量增加一倍多,廠商的收益幾乎增長三倍,一些大供應商在無線存儲市場出貨的90%是MCP,封裝技術與晶片工藝整合併進。
MCP關鍵技術半導體圓片後段製程技術加速發展,容許在適當的結構中,將某些、某類晶片整合在單一的一級封裝內,結構上分為金字塔式和懸樑式堆疊兩種,前者特點是從底層向上晶片尺寸越來越小,後者為疊層的晶片尺寸一樣大。MCP日趨定製化,能給顧客提供獨特的套用解決方案,比單晶片封裝具有更高的效率,其重要性與日劇增,所涉及的關鍵工藝包括如何確保產品合格率,減薄晶片厚度,若是相同晶片的層疊組裝和密集焊線等技術。