中國拳擊公開賽
 COB
COB中國拳擊公開賽(China Open of Boxing,簡稱COB )是迄今為止在亞洲舉辦的最高規格專業拳擊賽,首屆比賽於2010年4月5日在中國第一個奧運拳擊冠軍鄒市明的家鄉貴州的省會貴陽開幕。
集成快取
 COB封裝
COB封裝(Cache on board,板上集成快取)在處理器卡上集成
的快取,通常指的是二級快取,例:奔騰II
COB:(chip On board)被邦定在印製板上,由於IC供應商在LCD控制及相關晶片的生產上正在減小QFP(SMT零件的一種封裝方式)封裝的產量。因此,在今後的產品中傳統的SMT方式逐步被代替。
板上晶片
板上晶片(Chip On Board, COB)工藝過程首先是在基底表面用導熱環氧樹脂(一般用摻銀顆粒的環氧樹脂)復蓋矽片安放點,然後將矽片直接安放在基底表面,熱處理至矽片牢固地固定在基底為止,隨後再用絲焊的方法在矽片和基底之間直接建立電氣連線。裸晶片技術主要有兩種形式:一種是COB技術,另一種是倒裝片技術(Flip Chip)。板上晶片封裝(COB),半導體晶片交接貼裝在印刷線路板上,晶片與基板的電氣連線用引線縫合方法實現,並用樹脂復蓋以確保可靠性。雖然COB是最簡單的裸晶片貼裝技術,但它的封裝密度遠不如TAB和倒片焊技術
。
主要焊接方法
1:熱壓焊
利用加熱和加壓力使金屬絲與焊區壓焊在一起。其原理是通過加熱和加壓力,使焊區(如AI)發生塑性形變同時破壞壓焊界面上的氧化層,從而使原子間產生吸引力達到“鍵合”的目的,此外,兩金屬界面不平整加熱加壓時可使上下的金屬相互鑲嵌。此技術一般用為玻璃板上晶片COG。
2:超聲焊
超聲焊是利用超音波發生器產生的能量,通過換能器在超高頻的磁場感應下,迅速伸縮產生彈性振動,使劈刀相應振動,同時在劈刀上施加一定的壓力,於是劈刀在這兩種力的共同作用下,帶動AI絲在被焊區的金屬化層如(AI膜)表面迅速摩擦,使AI絲和AI膜表面產生塑性變形,這種形變也破壞了AI層界面的氧化層,使兩個純淨的金屬表面緊密接觸達到原子間的結合,從而形成焊接。主要焊接材料為鋁線焊頭,一般為楔形。
3:金絲焊
球焊在引線鍵合中是最具代表性的焊接技術,因為現在的半導體封裝二、三極體封裝都採用AU線球焊。而且它操作方便、靈活、焊點牢固(直徑為25UM的AU絲的焊接強度一般為0.07~0.09N/點),又無方向性,焊接速度可高達15點/秒以上。金絲焊也叫熱(壓)(超)聲焊主要鍵合材料為金(AU)線焊頭為球形故為球焊。
COB封裝流程
第一步:擴晶。採用擴張機將廠商提供的整張LED晶片薄膜均勻擴張,使附著在薄膜表面緊密排列的LED晶粒拉開,便於刺晶。
第二步:背膠。將擴好晶的擴晶環放在已刮好銀漿層的背膠機面上,背上銀漿。點銀漿。適用於散裝LED晶片。採用點膠機將適量的銀漿點在PCB印刷線路板上。
第三步:將備好銀漿的擴晶環放入刺晶架中,由操作員在顯微鏡下將LED晶片用刺晶筆刺在PCB印刷線路板上。
第四步:將刺好晶的PCB印刷線路板放入熱循環烘箱中恆溫靜置一段時間,待銀漿固化後取出(不可久置,不然LED晶片鍍層會烤黃,即氧化,給邦定造成困難)。如果有LED晶片邦定,則需要以上幾個步驟;如果只有IC晶片邦定則取消以上步驟。
第五步:粘晶片。用點膠機在PCB印刷線路板的IC位置上適量的紅膠(或黑膠),再用防靜電設備(真空吸筆或子)將IC裸片正確放在紅膠或黑膠上。
第六步:烘乾。將粘好裸片放入熱循環烘箱中放在大平面加熱板上恆溫靜置一段時間,也可以自然固化(時間較長)。
第七步:邦定(打線)。採用鋁絲焊線機將晶片(LED晶粒或IC晶片)與PCB板上對應的焊盤鋁絲進行橋接,即COB的內引線焊接。
第八步:前測。使用專用檢測工具(按不同用途的COB有不同的設備,簡單的就是高精密度穩壓電源)檢測COB板,將不合格的板子重新返修。
第九步:點膠。採用點膠機將調配好的AB膠適量地點到邦定好的LED晶粒上,IC則用黑膠封裝,然後根據客戶要求進行外觀封裝。
第十步:固化。將封好膠的PCB印刷線路板放入熱循環烘箱中恆溫靜置,根據要求可設定不同的烘乾時間。
第十一步:後測。將封裝好的PCB印刷線路板再用專用的檢測工具進行電氣性能測試,區分好壞優劣。
與其它封裝技術相比,COB技術價格低廉(僅為同晶片的1/3左右)、節約空間、工藝成熟。但任何新技術在剛出現時都不可能十全十美,COB技術也存在著需要另配焊接機及封裝機、有時速度跟不上以及PCB貼片對環境要求更為嚴格和無法維修等缺點。
某些板上晶片(CoB)的布局可以改善IC信號性能,因為它們去掉了大部分或全部封裝,也就是去掉了大部分或全部寄生器件。然而,伴隨著這些技術,可能存在一些性能問題。在所有這些設計中,由於有引線框架片或BGA標誌,襯底可能不會很好地連線到VCC或地。可能存在的問題包括熱膨脹係數(CTE)問題以及不良的襯底連線。
COB工藝流程
清潔PCB---滴粘接膠---晶片貼上---測試---封黑膠加熱固化---測試---入庫
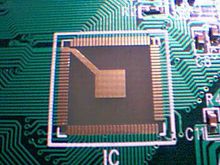 COB
COB1. 清潔PCB
清洗後的PCB板仍有油污或氧化層等不潔部分用皮擦試幫定位或測試針位對擦拭的PCB板要用毛刷刷乾淨或用氣槍吹淨方可流入下一工序。對於防靜電嚴的產品要用離子吹塵機。清潔的目的的為了把PCB板邦線焊盤上的灰塵和油污等清除乾淨以提高邦定的品質。
2. 滴粘接膠
滴粘接膠的目的是為了防止產品在傳遞和邦線過程中DIE脫落
在COB工序中通常採用針式轉移和壓力注射法
針式轉移法:用針從容器里取一小滴粘劑點塗在PCB上,這是一種非常迅速的點膠方法
壓力注射法:將膠裝入注射器內,施加一定的氣壓將膠擠出來,膠點的大小由注射器噴口口徑的大小及加壓時間和壓力大小決定與與粘度有關。此工藝一般用在滴粘機或DIE BOND自動設備上
膠滴的尺寸與高度取決於晶片(DIE)的類型,尺寸,與PAD位的距離,重量而定。尺寸和重量大的晶片膠滴量大一些,也不宜過大以保證足夠的粘度為準,同時粘接膠不能污染邦線焊盤。如要一定說是有什麼標準的話,那也只能按不同的產品來定。硬把什麼不能超過晶片的1/3高度不能露膠多少作為標準的話,實沒有這個必要。
3. 晶片貼上
晶片貼上也叫DIE BOND(固晶)粘DIE邦DIE 邦IC等各公司叫法不一。在晶片貼上中,要求真空吸筆(吸咀)材質硬度要小(也些公司採用棉簽貼上)。吸咀直徑視晶片大小而定,咀尖必須平整以免刮傷DIE表面。在貼上時須檢查DIE與PCB型號,貼上方向是否正確,DIE巾到PCB必須做到“平穩正”“平”就是指DIE與PCB平行貼緊無虛位“穩”是批DIE與PCB在整個流程中不易脫落“正”是指DIE與PCB預留位正貼,不可偏扭。一定要注意晶片(DIE)方向不得有貼反向之現象。
4. 邦線(引線鍵合)
邦線(引線鍵合)Wire Bond 邦定 連線叫法不一這裡以邦定為例
邦定依BONDING圖所定位置把各邦線的兩個焊點連線起來,使其達到電氣與機械連線。邦定的PCB做邦定拉力測試時要求其拉力符合公司所訂標準(參考1.0線大於或等於3.5G 1.25線大於或等於4.5G)鋁線焊點形狀為橢圓形,金線焊點形狀為球形。
邦定熔點的標準
鋁線:
線尾大於或等於0.3倍線徑小於或等於1.5倍線徑
焊點的長度 大於或等於1.5倍線徑 小於或等於5.0倍線徑
焊點的寬度 大於或等於1.2倍線徑 小於或等於3.0倍線徑
線弧的高度等於圓劃的拋物線高度(不宜太高不宜太低具體依產品而定)
金線:
焊球一般線上徑的2.6—2.7倍左右
在邦線過程中應輕拿輕放,對點要準確,操任人員套用顯微鏡觀察邦線過程,看有無斷線,卷線,偏位,冷熱焊,起鋁等到不良現象,如有則立即通知管理工或技術人員。在正式生產之前一定得有專人首檢,檢查其有無邦錯,少邦,漏邦拉力等現象。每隔2個小時應有專人核查其正確性。
5. 封膠
封膠主要是對測試OK之PCB板進行點黑膠。在點膠時要注意黑膠應完全蓋住PCB太陽圈及邦定晶片 鋁線,不可有露絲現象,黑膠也不可封出太陽圈以外及別的地方有黑膠,如有漏膠套用布條即時擦拭掉。在整個滴膠過程中針咀或毛簽都不可碰到DIE及邦定好的線。烘乾後的黑膠表面不得有氣孔,及黑膠未固化現象。黑膠高度不超過1.8MM為宜,特別要求的應小於1.5MM點膠時預熱板溫度及烘乾溫度都應嚴格控制。(振其BE-08黑膠FR4PCB板為例:預熱溫度120±15度時間為1.5—3.0分鐘 烘乾溫度為140±15度時間為40—60分鐘)封膠方法通常也採用針式轉移法和壓力注射法。有些公司也用滴膠機,但其成本較高效率低下。通常都採用棉簽和針筒滴膠,但對操作人員要有熟練的操作能力及嚴格的工藝要求。如果碰壞晶片再返修就會非常困難。所以此工序管理人員和工程人員必須嚴格管控。
6. 測試
因在邦定過程中會有一些如斷線,卷線,假焊等不良現象而導致晶片故障,所以晶片級封裝都要進行性能檢測
根據檢測方式可分非接觸式檢測(檢查)和接觸式檢測(測試)兩大類,非接觸式檢測己從人工目測發展到自動光學圖象分析(AOI)X射分析,從外觀電路圖形檢查發展到內層焊點質量檢查,並從單獨的檢查向質量監控和缺陷修補相結合的方向發展。
雖然邦定機裝有自動焊線質量檢測功能(BQM)因邦定機自動焊線質量檢測主要採用設計規則檢測(DRC)和圖形識別兩種方法。DRC是按照一些給定的規則如熔點小於線徑的多少或大於多少一些設定標準來檢查焊線質量。圖形識別法是將儲存的數位化圖象與實際工作進行比較。但這都受工藝控制,工藝規程,參數更改等方面影響。具體採用哪一種方法應根據各單位生產線具體條件,以及產品而定。但無論具備什麼條件,目視檢驗是基本檢測方法,是COB工藝人員和檢測人員必須掌握的內容之一。兩者之間應該互補,不能相互替代.
組裝技術
1.混合集成技術
當今電子產品的趨勢,在一個小型組件或整機內,不斷集成越來越多的器件和功能。混合集成技術成為增加包含有源與無源器件封裝密度的關鍵技術之一。
在混合集成各個製造步序,器件與電路間的互連,某些無源器件如電阻器等,直接在基板上採用厚膜或薄膜工藝澱積製成。混合積體電路基板布局布線的設計有許多重要的參數;導線寬度,導線與鍵合盤最近連線的布線,鍵合強度,鍵合引線弧環的高度,熱耗散等都必須加以考慮。
厚膜積體電路工藝,器件與電路間的互連,導線與電阻都是在基板上,採用各種功能漿料印刷燒結而成。薄膜積體電路工藝,互連與導線採用電鍍或其他PVD方法澱積在陶瓷基板上,光刻製作所需導電圖形,電阻與其他無源器件可印刷或焊接工藝裝連。當基板上的無源表貼器件全部裝連完成後,晶片貼上設備將電路晶片貼上到基板的給定位置,接下使用鍵合設備進行金絲或鋁絲的鍵合,實現晶片與基板電路間的電氣連線,最後封裝。
混合集成技術能在一個非常小的基板面積上集成大量電路晶片和小型無源器件。如果採用標準SMT表面貼裝工藝,勢必要占用比混合集成技術高達20倍的面積。
混合積體電路製造過程需要對半導體晶圓製造工藝,以及晶片組裝和鍵合工藝的全面掌握。一些小公司不具備這些條件,而且小批量製作混合電路組件,其成本相對是昂貴的。然而混合積體電路的套用涉及醫療,航天航空,軍用,汽車與通訊領域,在這些領域中,混合積體電路技術是不可缺少的。
2.COB晶片直接板上組裝技術
許多年來,業界致力於開發混合積體電路技術的優勢,但在製造成本沒獲突破。因此至今印製板組裝工藝在複雜電路裝聯仍不失為最好的選擇。只需對某些方面進行改進、裸晶片板上直接裝連鍵合工藝無疑是容易,可靠的。
COB晶片直接板上組裝技術首先用於數字鐘,手錶。每塊印製、電路板裝有一塊晶片,現已廣泛套用於數位相機,計算器,電話卡與各種智慧卡。COB在複雜的電路組件如裝有5,000個LED與IC驅動組合的的印表機模組,先進數據處理電路32bitHP9000計算機母板安裝22個IC與一塊modem電路等產品擴大了套用。
今天在單塊印製板組裝超過100個晶片的多晶片工藝也得到成功,日本的娛樂設備及乎所有電子組件都已採用COB技術,在某些套用領域COB大有取代SMT之勢。
成本分析表明DIP封裝成本經常高出其內含的晶片三倍之多。採用COB技術,省去了封裝成本可顯著降低,著在大批量生產尤為突出。
COB技術在歐洲起步晚,套用領域也正在不斷擴大,至今仍然無法與得以廣泛套用的日本和美國相比,尤其在高組裝密度與薄型封裝的套用方面。
3.COB組裝工藝
晶片板上直接組裝模組與混合積體電路的製造工藝是非常類似的。其主要的差別是兩者使用的基本材料與封裝形式,COB使用的基板是有機印製電路板,而後者是陶瓷基板。COB的裸晶片被高分子有機樹脂包封或球形塑封,混合積體電路最後使用金屬外殼封裝。與標準SMT組裝工藝比較,COB與混合集成組裝制過程的工藝步序較少。
印製板或PCB是由許多不同材料製成,如酚醛樹脂,聚氨基甲酸樹脂,聚醯胺樹脂,有機矽,氟塑膠等等,氟塑膠(聚四氟乙稀)在高溫環境下,具有高電阻的特性,聚氨基甲酸樹脂能適應特別大的溫度變化,如汽車電子,在非常高的溫度條件,要求極小的熱膨脹係數,此時氟塑膠是最能勝任的。
通常,COB印製板使用的導線材料為銅基導線,鍵合盤需要進行表面處理,在銅基材上鍍復2-4μm鎳,接下再鍍復0.1-0.2μm金(CuNiAu)
使用含銀環氧導電膠將晶片粘接到印製板安裝位置,在250℃固化。功率器件的散熱問題是通過晶片背面與粘接的印製板的銅層形成熱路,最後組裝時,冷卻板固定安裝在散熱指或封裝體上。
晶片與印製板間的電路連線使用鋁絲或金絲。鋁絲鍵合的最大優點是鍵合可在室溫進行。在產品承受高溫或大的溫度變化時,鋁絲超聲鍵合顯示很高的可靠性。金絲要達到鍵合可靠性需要在120℃以上的鍵合溫度。印製板使用的許多材料在較高溫度會變軟、甚至鍵合盤會被從印製板基材拉出脫離。當使用金絲與晶片上的鋁層鍵合盤進行鍵合時,如果要求最終產品需要承受較高的工作溫度,鍵合盤會存在損壞的危險。這種損壞的機理是由於Kirkendall孔隙造成鍵合盤被拉離。選擇鋁絲或金絲主要取決產品套用要求及工作的環境溫度。
完成引線鍵合後,晶片可使用多種工藝進行包封保護,有機矽可在室溫條件下固化,也有使用環氧或其他材料的黑膠。晶片也可使用塑膠或金屬殼進行封蓋,最後COB單元被裝入封裝腔體內,使用焊接或鍵合工藝實現電路連線。
4.鋁絲超聲鍵合工藝
產品需要高的鍵合質量時,通常使用鋁絲超聲鍵合工藝,其鍵合速度與金絲球焊工藝相比要慢得多,採用鋁絲鍵合工藝的最終產品因為材料表面處理的成本不貴,所以最終產品也是價低的。
鋁絲超聲鍵合實際是一種磨檫焊接工藝,兩種純金屬在予設定的壓力下,由超聲換能器產生的超聲振動相互加壓磨檫,直到完成磨檫鍵合。
超聲振動的幅度在1-2μm。
焊接過程可分為三部分,首先是清洗表面,其二,清除氧化層,第三是兩純金屬相互連線。這兩個金屬面相互受壓,其間的距離小於一個原子,得到的焊接是高質量高可靠的。
晶片金屬化層通常使用純鋁或鋁合金,厚度在0.8-2μm,特別適用與鋁絲超聲鍵合工藝。印製板鍵合盤是銅鎳金複合金屬層(Cu/Ni2-4μm/Au0.1-0.2μm)金層表面在加工過程中保護受雜質和化學物質的污染。在清洗表面時金層被去除,但這不影響鍵合過程,磨檫焊接在鋁絲與鎳層間發生。經測試評估得在穩定性,可靠性,導電性,特別的高使用溫度等鋁與鎳鍵合是最好的。
在印製板布局布線設計,有許多參數如鍵合盤尺寸,間距必須考慮。為避免在鍵合時產生一些問題,必須保證印製板具有高的平整度,不能變形。
鋁絲鍵合是室溫超聲焊接工藝,在焊接過程中應防止鍵合範圍的印製板移動或振動,因此在鍵合時,印製板必須採用真空負壓夾持固定。在鍵合盤鄰近區域的銅導線的粘合力也是基本因素,即使存在1μm的振動也會對鍵合產生不利影響。
印製板表面的均勻性是另一個因素,如鎳層的厚度變化或降低到0.5μm以下,則鍵合質量不穩定,鍵合力可能減少到另。在鍵合區內的銅層的粗糙度應受控制小於2μm。這是由超聲振動能補償的最大偏差。
5. 金絲球焊工藝
與鋁絲超聲鍵合不同,金絲球焊不能在室溫條件下進行,其至少在120℃才可得到合格的焊接質量。金絲球焊與鋁絲鍵合一樣,在焊接過程,為避免表面溫度的變化及超聲功率損失,印製板必須保持平整。
鍵合盤表面金屬化處理,鎳層厚1μm,金層1.5-2μm(CuNiAu)。印製板因使用貴金屬加工成本高於鋁絲鍵合印製板,金絲球焊的速度比鋁絲鍵合快三倍。由於鋁絲是低溫焊接工藝,需要更大的超聲功率與精密的鍵合工作檯夾持固定印製板,於是影響整個產能。超聲鍵合使用劈刀及金絲球焊的毛細管,工具類型也影響加工的速度。
6.COB與封裝工藝
封裝除了將晶片與外界隔離保護作用外,還有電路的連線。
標準的封裝形式有限,且引腳的數量也是標準的。這就意味著如需要額外的電氣連線,則必須選用較大的封裝,這樣勢必會增加封裝的尺寸與成本。
超過100個引腳的晶片一般需要價高的封裝,有時封裝的幾何尺寸給鍵合帶來許多難度,造成對晶片的損壞。專用積體電路ASIC通常是小批量生產,增加了選擇相應的封裝的困難。但最大困難是如何滿足要求儘可能高引腳數專用封裝的用戶。
使用現在的技術在非常短時間需要設計的印製板實現大量的互連,今天COB技術能為其提供滿意的方案。
在非常少生產量或低的加工成本,大量的晶片連線與互連可以正確得到解決。引線鍵合完成後,電路晶片與所有的鍵合引線採用上述的工藝進行包封。對於需要智慧財產權保護的小批量ASIC組件,不能容易被複製,這種封裝提供了優點。而且無源器件與其他晶片也可集成在同一個封裝內。
COB封裝方法的優點首先是封裝體積小型化,而標準封裝尺寸往往是晶片的10倍。其二,高引腳數ASIC的標準封裝的成本經常比晶片自身大得多。
7.COB引線鍵合設備
從經驗得到使用COB技術加工90%的產品需要100×100mm印製板,每塊印製板晶片少於100,所以用於COB的鍵合設備必需滿足下面的最低要求;
加工的印製板最小尺寸100×100mm。
圖形識別,需存貯多於200個參考圖形。
多晶片高度,可程式聚焦。
對不同反差的晶片加工,大於4個可程式光源。
精細落地模式,適用不平整表面。
檢測引線損耗的引線控制裝置。
大的Z軸行程,適應大尺寸電容器的加工。
辟刀鍵合時,具有60度彎曲的能力。
真空夾持印製板。
鍵合工具應有足夠的空間,滿足深腔體封裝的鍵合要求。
柔行傳動系統,裝載25-15-mm長度印製板
8.COB晶片粘接設備
COB晶片粘接設備的主要功能如下;
加工的印製板最小尺寸100×100mm。
膠點或邊沿識別功能,圖形識別,需存貯多於100個參考圖形。
多晶片高度,可程式聚焦。
適合晶圓,華夫盤或Gel包裝晶片送料裝置。
能滿足至少4種不同尺寸晶片的可程式點膠裝置。
在程式控制下,可選擇或更換需要採用印刷或點膠方法的能力。
鍵合工具應有足夠的空間,滿足深腔體封裝的鍵合要求。
柔行傳動系統,裝載25-15-mm長度印製板
9.結 論
文章所述COB印製板的工藝參數在設計時,必須加以考慮。掌握這些基本要求,各種可變因素在控制條件下,COB具有在裝載,封裝,組裝密度,可靠性等優點,且與標準SMT工藝相比,可減少產品的製造成本。
鏇律死亡金屬樂隊
指芬蘭大牌鏇律死亡金屬樂隊 Children Of Bodom
COB
China Overseas Buildings(中國海外集團)
China Overseas Buildings,中國海外集團於1979年6月在香港成立,隸屬於中國建築工程總公司。
福利協調
來源於醫療保險行業。參保人在參加了多家保險單位的時候,在獲得需要的醫療服務後,需要這些保險單位來共同協定賠付標準。這樣可以避免多方賠付致使賠付款項超出了受保人實際的醫療開銷。
CLOSEOFBUSINESS下班
COB的英文全寫CLOSE OF BUSINESS,意思是在工作時間結束的時候。例如:You should submit a report by COB. 你應該在下班前提交報告。
電子信息工程
| 電子信息工程,就是將信息(文字的、聲音的、圖像的、甚至於,在將來,感覺的,味道的,心理的)運用電子方式來轉化、保存、傳遞的一系列設施以及涉及到的種種技術的綜合。電子信息工程就是資訊時代的基礎設施。網際網路、固定電話網、行動電話網等等,是日常熟悉的電子信息工程。電子信息工程是理工兼備,傾向於工科,也就是技術和實際操作的技能。 |

