銅連線技術
 銅連線技術
銅連線技術銅連線的優點
和鋁連線相比,銅連線有許多優點:
(1)銅連線的電阻R比鋁連線小。銅的電阻率為1.7μΩ/cm,
鋁的電阻率為3.1μΩ/cm,銅的電阻率較低,因而減少了阻容(RC)延遲,改善了性能。
(2)銅連線的寄生電容比鋁連線小。因為銅的電阻率低,導電性能好,在承受相同電流時,銅連線截面積比鋁連線小,因而相鄰連線間的寄生電容C小,信號串擾也小。這就是說,銅連線的時間常數RC比鋁連線小,信號在銅連線上傳輸的速度比在鋁連線上快,這對高速IC是很有利的。
(3)銅連線的電阻小,導致銅連線IC功耗比鋁連線IC功耗低,這很有利於電池供電的筆記本電腦和移動通信設備。
(4)銅的另一個優點是它的耐電遷移性能遠比鋁好。IBM公司發現,與傳統的鋁連線相比,銅連線的抗電遷移性能提高了兩個數量級,而且沒有因應力遷移而產生連線空洞,因而有利於IC可靠性的提高。
 銅連線技術
銅連線技術(6)銅連線還提供了更小的時鐘和信號畸變,改善了片上功率分配。
另外,銅連線的布線層數目比鋁連線少,對某些IC器件,銅連線的層數只有鋁連線的一半。上述兩點都能明顯降低銅連線IC的製造成本。銅金屬工藝被認為是下一代晶片的方向,但此前一直沒有實現量產。
由於銅連線IC的速度、功耗、可靠性等性能好、成本低,許多大型積體電路製造工廠都開展了IC銅連線開發項目。IBM公司開發了CMOS 7S工藝,該工藝用六層銅連線,電晶體的有效溝道長度為0.12μm(版圖上為0.2μm),電源電壓1.8V,集成度高達200萬個電晶體。1998年1月,IBM已將CMOS 7S工藝用於生產專用積體電路ASIC。Motorola公司的開發項目與IBM相似,它的第一批產品是快速靜態隨機存儲器SRAM。
銅連線降低了電容和信號串擾效應,若將銅連線和低介電常數的絕緣材料相結合,這種銅/低介電常數介質連線,速度將會更快,串擾將會更小。TI公司將低介電常數介質技術用於銅連線工藝中,耗資1.5億美元建成了新的中心進行銅/低介電常數介質連線技術的開發項目。3年前該公司就開始低介電常數介質——一種矽基介質的研究開發工作,早期開發的介質稱為xerogel,是一種多孔二氧化矽,它的介電常數會隨氣孔率而變,用氣孔率為75%、介電常數為1.8的xerogel製成銅/xerogel連線,電阻比鋁/二氧化矽連線降低30%,電容降低14%。近來TI公司又開發出稱作納米玻璃的介質,它的介電常數能在1.3到2.5之間變化。這種低介電常數介質可用慣用的自鏇鍍膜機鍍到矽片上,然後烘乾排除溶劑。和xerogel相比,它在幾分鐘內便可排除溶劑,而xerogel需要數小時。而且納米玻璃溫度穩定性也比xerogel好,在800℃下仍很穩定。TI公司研究了0.3μm銅/納米玻璃連線IC,和鋁/二氧化矽連線IC相比,電阻相同時,電容下降36%;電容相同時,電阻下降46%;RC性能幾乎提高1倍。
銅連線製作工藝
綜上所述,銅連線技術的優點是明顯的,那么為何銅連線技術遲到今天才開始用於IC生產上呢?原因很多,其中最主要的是銅和鋁的重大區別:銅是快擴散物質,一旦進入器件的有源區(電晶體的源/漏/柵區),器件就會失效。這就要求開發出全新工藝,保證銅連線和IC的其他部分完全隔離。
IBM公司最先開發出雙鑲嵌(dual damascene)工藝。圖1是由雙鑲嵌工藝實現的銅連線結構,在半導體晶片上,依次是絕緣介質層、阻擋銅擴散的鉭/氮化鉭阻擋層、銅籽晶層、填充引線溝槽的電鍍銅層。
圖2是雙鑲嵌工藝的主要流程:(1)介質層沉積;(2)接線“柱”光刻和反應離子腐蝕;(3)連線光刻和反應離子腐蝕;(4)接線“柱”和連線溝槽電鍍銅填充;(5)金屬化學-機械拋光;最後在拋光後的銅上覆蓋一層氮化矽。
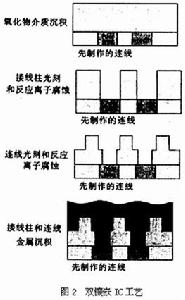 銅連線技術
銅連線技術圖3是IBM的CMOS 7S工藝製作的六層銅連線。
銅引線鑲嵌工藝是在一種古老的技藝基礎上開發出來的。在該技藝中,用金屬填滿從周圍材料中挖出的溝槽的辦法來得到所需要的金屬線圖案,在雙鑲嵌IC工藝中,用電鍍銅填滿在絕緣介質中挖出的接線“柱”和連線溝槽,然後進行化學-機械拋光使其高度平整。可見銅澱積是十分重要的。現在有5種澱積銅的工藝,即:PVD,CVD,電離PVD,電鍍和化學鍍。目前還很難說哪種工藝最好。IBM採用的電鍍工藝,要求在阻擋層之上澱積約500厚的銅籽晶層。通常,籽晶層是用PVD法澱積的,人們也在研究用CVD法澱積銅籽晶層。有廠商計畫於1999年推出用於澱積阻擋層和銅籽晶層的新設備。估計第一個用這種設備實現的阻擋層/籽晶層工藝將是PVD鉭和CVD銅工藝。
最佳IC連線系統是銅/低介電常數介質連線系統,與傳統的鋁/二氧化矽連線系統相比,它有如下優點:金屬連線層數目少;晶片速度高、功耗低;製造成本低;耐電遷移性能好、晶片可靠性高。

