正文
其厚度很薄,一般在數十埃至幾微米範圍內。為適應各種成分和結構的薄層的測厚要求,已研製成各種測量設備。例如,採用比色法、干涉條紋法以及橢偏術等測量各種透明薄膜;採用磨角染色法、層錯法、紅外光反射法以及背散射技術等檢驗外延層厚度、擴散層和離子注入層的深度;採用間接干涉法和台階儀等測量金屬膜和多晶矽的厚度等。比色法 半導體晶片上的透明介質膜受白光垂直照射時,部分光線在介質膜表面直接反射,另一部分則透過介質膜並在膜與襯底的界面反射後再透射出來。由於這兩部分光束之間存在著光程差而產生光的干涉。光程差的數值取決於膜的厚度,光的相長干涉的結果就會使一定厚度的介質膜呈現出特定的顏色。這樣,根據介質膜在垂直光照下的顏色就可判定出膜的厚度。通過用其他更為準確的方法所測定的厚度作為標準,已建立起顏色和厚度的詳細對照表。為了避免誤差,還可以設定一套標準比色樣品進行對照判定。測量範圍在500埃至1.5微米之間。
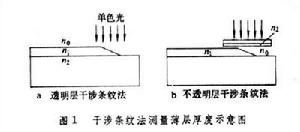 薄層厚度測量技術
薄層厚度測量技術

採用干涉條紋法測量薄層的最低厚度與精度都不足一個條紋的厚度,最佳可達0.1個條紋厚。
磨角染色法 此法普遍套用於外延層、擴散層和離子注入層等深度的測量中。測前先把樣品固定在具有小傾角θ的金屬塊上,並研磨出傾角為θ 的斜面(圖2)。然後,把樣品放在一種合適的溶液中染色,由於選擇化學反應的結果,使某一區域(如PN結的P型區)出現較深的顏色。這樣,就可在顯微鏡下觀測出待測區的長度l。若θ小於1°,則斜邊所對應的厚度xj=θl。此外,也可在磨角染色後,採用間接干涉條紋法測量l長度的範圍內出現的亮條數計算厚度。用此法測量半導體中的異型層時(如PN結的結深),精度一般約在 0.5微米。它也能用於測量兩層之間的電阻率相差很大的同型層(一個數量級以上),但精度較差。
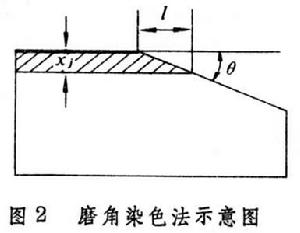 薄層厚度測量技術
薄層厚度測量技術
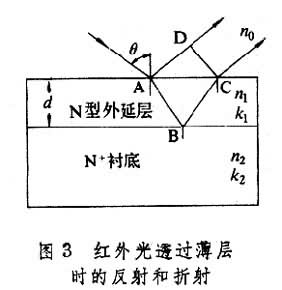 薄層厚度測量技術
薄層厚度測量技術 薄層厚度測量技術
薄層厚度測量技術 薄層厚度測量技術
薄層厚度測量技術
 (d為厚度,n1和n0分別為薄膜和空氣的折射係數)。
(d為厚度,n1和n0分別為薄膜和空氣的折射係數)。 和
和 分別為p分量和s分量在界面1處的費涅爾反射係數;
分別為p分量和s分量在界面1處的費涅爾反射係數; 和
和 分別為上述兩分量在界面 2處的費涅爾反射係數。它們各與兩個界面的光學常數和入射角有關。採用橢偏儀(圖6)可測量出φ 和Δ兩個參數,由計算機解上述橢偏方程以確定膜厚與薄膜的光學常數。此法具有精度高、非破壞性等優點,能測出薄達幾個埃的極薄的薄層厚度。採用光度法橢偏術測試,易於實現自動化實時測量。
分別為上述兩分量在界面 2處的費涅爾反射係數。它們各與兩個界面的光學常數和入射角有關。採用橢偏儀(圖6)可測量出φ 和Δ兩個參數,由計算機解上述橢偏方程以確定膜厚與薄膜的光學常數。此法具有精度高、非破壞性等優點,能測出薄達幾個埃的極薄的薄層厚度。採用光度法橢偏術測試,易於實現自動化實時測量。  薄層厚度測量技術
薄層厚度測量技術 薄層厚度測量技術
薄層厚度測量技術 薄層厚度測量技術
薄層厚度測量技術x =n1dcosθ
=n1dcosθ
 為側脈衝最大峰的位置;d為膜厚;θ為入射角;n1為膜的折射係數。已知x
為側脈衝最大峰的位置;d為膜厚;θ為入射角;n1為膜的折射係數。已知x ,可得到外延層的厚度。此法同紅外反射法相比,除具有多路復用等優點外,還有信噪比好(光通量大)、結構可靠、容量大、快速(20~30秒)、精密(±0.005微米)、精確(在500埃以內)以及簡便等優點。若使用可見光光源時,可測量各種透明膜的厚度,這是一項較好的非破壞性測量技術。
,可得到外延層的厚度。此法同紅外反射法相比,除具有多路復用等優點外,還有信噪比好(光通量大)、結構可靠、容量大、快速(20~30秒)、精密(±0.005微米)、精確(在500埃以內)以及簡便等優點。若使用可見光光源時,可測量各種透明膜的厚度,這是一項較好的非破壞性測量技術。