正文
在單晶襯底(基片)上生長一層有一定要求的、與襯底晶向相同的單晶層,猶如原來的晶體向外延伸了一段,故稱外延生長。外延生長技術發展於50年代末60年代初。當時,為了製造高頻大功率器件,需要減小集電極串聯電阻,又要求材料能耐高壓和大電流,因此需要在低阻值襯底上生長一層薄的高阻外延層。外延生長的新單晶層可在導電類型、電阻率等方面與襯底不同,還可以生長不同厚度和不同要求的多層單晶,從而大大提高器件設計的靈活性和器件的性能。外延工藝還廣泛用於積體電路中的PN結隔離技術(見隔離技術)和大規模積體電路中改善材料質量方面。
原理生長外延層有多種方法,但採用最多的是氣相外延工藝。圖1為矽(Si)氣相外延的裝置原理圖。氫(H
)氣攜帶四氯化矽(SiCl
)或三氯氫矽(SiHCl
)、矽烷(SiH
)或二氯氫矽(SiH
Cl
)等進入置有矽襯底的反應室,在反應室進行高溫化學反應,使含矽反應氣體還原或熱分解,所產生的矽原子在襯底矽表面上外延生長。其主要化學反應式為
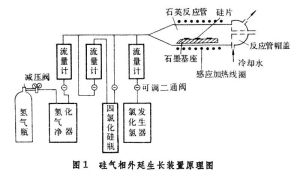 外延生長
外延生長 外延生長
外延生長矽片外延生長時,常需要控制摻雜,以保證控制電阻率。N型外延層所用的摻雜劑一般為磷烷(PH
)或三氯化磷(PCl
);P型的為乙硼烷(B
H
)或三氯化硼(BCl
)等。
外延生長過程氣相外延生長常使用高頻感應爐加熱,襯底置於包有碳化矽、玻璃態石墨或熱分解石墨的高純石墨加熱體上,然後放進石英反應器中。此外,也有採用紅外輻照加熱的。為了製備優質的外延層,必須保證原料的純度。對於矽外延生長,氫氣必須用鈀管或分子篩等加以淨化,使露點在-70
 外延生長
外延生長以下,還要有嚴密的系統,因微量水汽或氧的泄漏會產生有害的影響;為獲得平整的表面,襯底必須嚴格拋光並防止表面有顆粒或化學物質的沾污;在外延生長前,反應管內在高溫下用乾燥氯化氫、溴或溴化氫進行原位拋光,以減少層錯缺陷;為減少位錯須避免襯底邊緣損傷、熱應力衝擊等;為得到重複均勻的厚度和摻雜濃度分布,還須控制溫度分布和選擇合適的氣流模型。
外延層質量檢測對外延片檢查主要包括:表面質量(不應有突起點、凹坑等)、導電類型、電阻率、外延層厚度、外延片(片中和各片間的均勻性)和缺陷密度(包括層錯、位錯、霧狀微缺陷或小丘)等。
外延工藝進展為了克服外延工藝中的某些缺點,外延生長工藝已有很多新的進展。①減壓外延:自摻雜現象是使用鹵素化合物作源的外延過程中難以避免的現象,即從基片背面、加熱體表面以及從前片向後片,都會有摻雜劑遷移到氣相而再進入到外延層。自摻雜使外延層雜質濃度不均勻。若將反應管中的壓力降到約 160托,即可有效地減少自摻雜。②低溫外延:為得到襯底與薄外延層之間的突變結,需要降低生長溫度,以減少基片中的雜質向外延層的自擴散。採用He-SiH
分解、SiH
Cl
熱分解以及濺射等方法都可明顯降低溫度。③選擇外延:用於製備某些特殊器件,襯底上有掩模並在一定區域開有視窗,單晶層只在開視窗的區域生長,而留有掩模的區域不再生長外延層。④液相外延:將生長外延層的原料在溶劑中溶解成飽和溶液。當溶液與襯底溫度相同時,將溶液復蓋在襯底上,緩慢降溫,溶質按基片晶向析出單晶。這種方法常用於外延生長砷化鎵等材料。⑤異質外延:襯底與外延層不是同一種物質,但晶格和熱膨脹係數比較匹配。這樣就能在一個襯底上外延生長出不同的晶膜,如在藍寶石或尖晶石襯底上外延生長矽單晶。⑥分子束外延:這是一種最新的晶體生長技術(圖2)。將襯底置於超高真空腔中,將需要生長的單晶物質按元素不同分別放在噴射爐中。每種元素加熱到適當的溫度,使其以分子流射出,即可生長極薄(甚至是單原子層)的單晶層和幾種物質交替的超晶格結構。
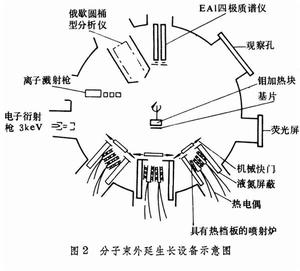 外延生長
外延生長氮化物襯底材料
氮化物襯底材料的研究與開發增大字型復位寬頻隙的GaN基半導體在短波長發光二極體、雷射器和紫外探測器,以及高溫微電子器件方面顯示出廣闊的套用前景;對環保,其還是很適合於環保的材料體系
 外延生長
外延生長。半導體照明產業發展分類所示的若干主要階段,其每個階段均能形成富有特色的產業鏈。世界各國現在又投入了大量的人力、財力和物力,以期望取得GaN基高功率器件的突破,並且居於此領域的制高點。“氮化物襯底材料與半導體照明的套用前景”文稿介紹了氮化物襯底材料與半導體照明的套用前景的部分內容。
GaN、AlN、InN及其合金等材,是作為新材料的GaN系材料。對襯底材料進行評價要就襯底材料綜合考慮其因素,尋找到更加合適的襯底是發展GaN基技術的重要目標。評價襯底材料要綜合考慮襯底與外延膜的晶格匹配、襯底與外延膜的熱膨脹係數匹配、襯底與外延膜的化學穩定性匹配、材料製備的難易程度及成本的高低的因素。InN的外延襯底材料就現在來講有廣泛套用的。自支撐同質外延襯底的研製對發展自主智慧財產權的氮化物半導體雷射器、大功率高亮度半導體照明用LED,以及高功率微波器件等是很重要的。“氮化物襯底材料的評價因素及研究與開發”文稿介紹了氮化物襯底材料的評價因素及研究與開發的部分內容。
外延襯底材料的研究與開發
InN的外延襯底材料就現在來講有廣泛套用的,其中有:InN;α-Al2O3(0001);6H-SiC;MgAl2O4(111);LiAlO2和LiGaO2;MgO;Si;GaAs(111)等。
Ⅲ-Ⅴ族化合物,例如,GaN、AlN、InN,這些材料都有二種結晶形式:一種是立方晶系的閃鋅礦結構,而另一種是六方晶系的纖鋅礦結構。以藍光輻射為中心形成研究熱點的是纖鋅礦結構的氮化鎵、氮化鋁、氮化銦,而且主要是氮化鎵、氮化鋁、氮化銦的固溶體。這些材料的禁帶是直接躍遷型,因而有很高的量子效率。用氮化鎵、氮化鋁、氮化銦這三種材料按不同組份和比例生成的固溶體,其禁頻寬度可在2.2eV到6.2eV之間變化。這樣,用這些固溶體製造發光器件,是光電集成材料和器件發展的方向。
(1)InN和GaN
因為異質外延氮化物薄膜通常帶來大量的缺陷,缺陷損害了器件的性能。與GaN一樣,如果能在InN上進行同質外延生長,可以大大減少缺陷,那么器件的性能就有巨大的飛躍。
自支撐同質外延GaN,AlN和AlGaN襯底是目前最有可能首先獲得實際套用的襯底材料。
(2)藍寶石(α-Al2O3)和6H-SiC
α-Al2O3單晶,即藍寶石晶體。(0001)面藍寶石是目前最常用的InN的外延襯底材料。其匹配方向為:InN(001)//α-Al2O3(001),InN//α-Al2O3[11,12]。因為襯底表面在薄膜生長前的氮化中變為AlON,InN繞α-Al2O3(0001)襯底的六面形格子結構鏇轉30°,這樣其失匹配度就比原來的29%稍有減少。雖然(0001)面藍寶石與InN晶格的失配率高達25%,但是由於其六方對稱,熔點為2050℃,最高工作溫度可達1900℃,具有良好的高溫穩定性和機械力學性能,加之對其研究較多,生產技術較為成熟,而且價格便宜,現在仍然是套用最為廣泛的襯底材料。
6H-SiC作為襯底材料套用的廣泛程度僅次於藍寶石。同藍寶石相比,6H-SiC與InN外延膜的晶格匹配得到改善。此外,6H-SiC具有藍色發光特性,而且為低阻材料,可以製作電極,這就使器件在包裝前對外延膜進行完全測試成為可能,因而增強了6H-SiC作為襯底材料的競爭力。又由於6H-SiC的層狀結構易於解理,襯底與外延膜之間可以獲得高質量的解理面,這將大大簡化器件的結構;但是同時由於其層狀結構,在襯底的表面常有給外延膜引入大量的缺陷的台階出現。
(3)鎂鋁尖晶石(MgAl2O4)
MgAl2O4晶體,即鋁酸鎂晶體。MgAl2O4晶體是高熔點(2130℃)、高硬度(莫氏8級)的晶體材料,屬面心立方晶系,空間群為Fd3m,晶格常數為0.8085nm。MgAl2O4晶體是優良的傳聲介質材料,在微波段的聲衰減低,用MgAl2O4晶體製作的微波延遲線插入損耗小。MgAl2O4晶體與Si的晶格匹配性能好,其膨脹係數也與Si相近,因而外延Si膜的形變扭曲小,製作的大規模超高速積體電路速度比用藍寶石製作的速度要快。此外,國外又用MgAl2O4晶體作超導材料,有很好的效果。近年來,對MgAl2O4晶體用於GaN的外延襯底材料研究較多。由於MgAl2O4晶體具有良好的晶格匹配和熱膨脹匹配,(111)面MgAl2O4晶體與GaN晶格的失配率為9%,具有優良的熱穩定性和化學穩定性,以及良好的機械力學性能等優點,MgAl2O4晶體目前是GaN較為合適的襯底材料之一,已在MgAl2O4基片上成功地外延出高質量的GaN膜,並且已研製成功藍光LED和LD。此外,MgAl2O4襯底最吸引人之處在於可以通過解理的方法獲得雷射腔面。
在前面的研究基礎上,近來把MgAl2O4晶體用作InN的外延襯底材料的研究也陸續見之於文獻報導。其之間的匹配方向為:InN(001)//MgAl2O4(111),InN//MgAl2O4,InN繞MgAl2O4(111)襯底的四方、六方形格子結構鏇轉30°。研究表明(111)面MgAl2O4晶體與InN晶格的失配率為15%,晶格匹配性能要大大優於藍寶石,(0001)面藍寶石與InN晶格的失配率高達25%。而且,如果位於頂層氧原子層下面的鎂原子占據有效的配位晶格位置,以及氧格位,那么這樣可以有希望將晶格失配率進一步降低至7%,這個數字要遠遠低於藍寶石。所以MgAl2O4晶體是很有發展潛力的InN的外延襯底材料。
(4)LiAlO2和LiGaO2
以往的研究是把LiAlO2和LiGaO2用作GaN的外延襯底材料。LiAlO2和LiGaO2與GaN的外延膜的失配度相當小,這使得LiAlO2和LiGaO2成為相當合適的GaN的外延襯底材料。同時LiGaO2作為GaN的外延襯底材料,還有其獨到的優點:外延生長GaN後,LiGaO2襯底可以被腐蝕,剩下GaN外延膜,這將極大地方便了器件的製作。但是由於LiGaO2晶體中的鋰離子很活潑,在普通的外延生長條件下(例如,MOCVD法的化學氣氛和生長溫度)不能穩定存在,故其單晶作為GaN的外延襯底材料還有待於進一步研究。而且在目前也很少把LiAlO2和LiGaO2用作InN的外延襯底材料。
(5)MgO
MgO晶體屬立方晶系,是NaCl型結構,熔點為2800℃。因為MgO晶體在MOCVD氣氛中不夠穩定,所以對其使用少,特別是對於熔點和生長溫度更高的InN薄膜。
(6)GaAs
GaAs(111)也是目前生長InN薄膜的襯底材料。襯底的氮化溫度低於700℃時,生長InN薄膜的厚度小於0.05μm時,InN薄膜為立方結構,當生長InN薄膜的厚度超過0.2μm時,立方結構消失,全部轉變為六方結構的InN薄膜。InN薄膜在GaAs(111)
襯底上的核化方式與在α-Al2O3(001)襯底上的情況有非常大的差別,InN薄膜在GaAs(111)襯底上的核化方式沒有在白寶石襯底上生長InN薄膜時出現的柱狀、纖維狀結構,表面上顯現為非常平整。
(7)Si
單晶Si,是套用很廣的半導體材料。以Si作為InN襯底材料是很引起注意的,因為有可能將InN基器件與Si器件集成。此外,Si技術在半導體工業中已相當的成熟。可以想像,如果在Si的襯底上能生長出器件質量的InN外延膜,這樣則將大大簡化InN基器件的製作工藝,減小器件的大小。
(8)ZrB2
ZrB2是2001年日本科學家首次提出用於氮化物外延新型襯底。ZrB2與氮化物晶格匹配,而且其具有匹配的熱膨脹係數和高的電導率。主要用助熔劑法和浮區法生長。
自支撐同質外延襯底的研製對發展自主智慧財產權的氮化物半導體雷射器、大功率高亮度半導體照明用LED,以及高功率微波器件等是很重要的。