概述
 原子層沉積系統
原子層沉積系統原子層沉積最初是由芬蘭科學家提出並用於多晶螢光材料以及非晶絕緣膜的研製,這些材料是用於平板顯示器。由於這一工藝涉及複雜的表面化學過程和低的沉積速度,直至上世紀80年代中後期該技術並沒有取得實質性的突破。但是到了20世紀90年代中期,人們對這一技術的興趣在不斷加強,這主要是由於微電子和深亞微米晶片技術的發展要求器件和材料的尺寸不斷降低,而器件中的高寬比不斷增加,這樣所使用材料的厚度降低值幾個納米數量級。因此原子層沉積技術的優勢就體現出來,如單原子層逐次沉積,沉積層極均勻的厚度和優異的一致性等就體現出來,而沉積速度慢的問題就不重要了。以下主要討論原子層沉積原理和化學,原子層沉積與其他相關技術的比較,原子層沉積設備,原子層沉積的套用和原子層沉積技術的發展。
原理
原子層沉積是通過將氣相前驅體脈衝交替地通入反應器並在沉積基體上化學吸附並反應並形成沉積膜的一種方法(技術)。當前軀體達到沉積基體表面,它們會在其表面化學吸附並發生表面反應。在前驅體脈衝之間需要用惰性氣體對原子層沉積反應器進行清洗。由此可知沉積反應前驅體物質能否在被沉積材料表面化學吸附是實現原子層沉積的關鍵。氣相物質在基體材料的表面吸附特徵可以看出,任何氣相物質在材料表面都可以進行物理吸附,但是要實現在材料表面的化學吸附必須具有一定的活化能,因此能否實現原子層沉積,選擇合適的反應前驅體物質是很重要的。
 原子層沉積系統
原子層沉積系統原子層沉積的表面反應具有自限制性,實際上這種自限制性特徵正是原子層沉積技術的基礎。不斷重複這種自限制反應就形成所需要的薄膜。
原子層沉積的自限制特徵 :根據沉積前驅體和基體材料的不同,原子層沉積有兩種不同的自限制機制,即化學吸附自限制和順次反應自限制過程。
化學吸附自限制沉積過程中,第一種反應前驅體輸入到基體材料表面並通過化學吸附(飽和吸附)保持在表面。當第二種前驅體通入反應器,起就會與已吸附於基體材料表面的第一前驅體發生反應。兩個前驅體之間會發生置換反應並產生相應的副產物,直到表面的第一前驅體完全消耗,反應會自動停止並形成需要的原子層。因此這是一種自限制過程,而且不斷重複這種反應形成薄膜。
與化學吸附自限制過程不同,順次反應自限制原子層沉積過程是通過活性前驅體物質與活性基體材料表面化學反應來驅動的。這樣得到的沉積薄膜是由於前驅體與基體材料間的化學反應形成的。
專利
原子層沉積一種原子層沉積方法,包括將半導體基材放置在原子層沉積室內。第一前體氣體流過原子層沉積室內的基材上以在基材上有效形成第一單層。在形成第一單層後,反應性中間體氣體流向沉積室內的基材。反應性中間體氣體在反應性中間體氣體的流動的條件下能夠與來自第一前體流的中間反應副產物反應。在反應性中間體流過後,第二前體氣體流向沉積室內的基材,以在第一單層上有效形成第二單層。
分析
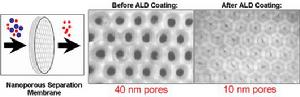 原子層沉積原理
原子層沉積原理從原理上說,ALD是通過化學反應得到生成物,但在沉積反應原理、沉積反應條件的要求和沉積層的質量上都與傳統的CVD不同,在傳統CVD工藝過程中,化學蒸汽不斷通入真空室內,因此該沉積過程是連續的,沉積薄膜的厚度和溫度、壓力、氣體流量以及流動的均勻性、時間等多種因素有關;在ALD工藝過程中,則是將不同的反應前驅物以氣體脈衝的形式交替送入反應室中,因此並非一個連續的工藝過程。相對於傳統的沉積工藝而言,ALD在膜層的均勻性、階梯覆蓋率以及厚度控制等方面都具有明顯的優勢。
在某些套用中,需要在具有很大長徑比的內腔表面鍍膜,極限的情況下長徑比會達到15甚至20,採用傳統的鍍膜方法是無法實現的,而原子層沉積技術由於是通過在基底表面形成吸附層,進一步通過反應生成薄膜,因而在這方面具有獨特的優勢,可以在大長徑比的內腔表面形成厚度均勻的薄膜。
 工作原理圖
工作原理圖近年來,對於X射線譜段光學薄膜的需求和研究也日益增加。由於材料的光學常數和性能在X射線區隨波長的變化非常顯著,同時,在X射線多層膜製備過程中,對基底表面粗糙度要求很高,膜層也很薄,難於控制,這些問題目前在光學薄膜的研究中,仍然是研究的難點。由於ALD技術是通過反應前驅物在表面形成化學吸附後,反應生成薄膜,其主要特點是適合沉積厚度很薄的薄膜,而且成膜質量很好,在X射線光學薄膜器件製備方面具有絕對優勢。
光子晶體是20世紀80年代末提出的新概念和新材料,由於存在光子禁帶和光子局域而具有很廣泛的套用前景。由於光子晶體是一種人造微結構,自然界裡只存在有限幾種,因此,光子晶體的製作技術,一直是研究的熱點。原子層沉積技術由於可以精確控制膜層,所獲得的高度均勻的表面對光子禁帶特性有很大影響,為獲得高性能光子晶體結構提供了一條靈活有效的途徑。
研究
原子層沉積(ALD)的自限制性和互補性致使該技術對薄膜的成份和厚度具有出色的控制能力,所製備的薄膜保形性好、純度高且均勻,因而引起了人們廣泛的關注。原子尺度上的ALD過程仿真對深入了解沉積機理,改進和最佳化薄膜生長工藝,提高薄膜質量,改善薄膜性質具有重要意義。在深入了解ALD的工藝特點及工藝過程後,針對H-Si(100)表面上沉積Al<,2>O<,3>的ALD過程的仿真進行了多方面的探索研究,並取得了一些創新性結果。
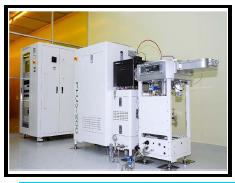 原子層沉積大型儀器
原子層沉積大型儀器1)提出ALD過程通常存在初始沉積和後續生長兩個不同的沉積階段,薄膜的生長模式分別表現為島狀生長和層狀生長,其中初始沉積階段對薄膜形態有著不可忽略的影響。
2)以Al<,2>O<,3>的ALD過程為參考,給出了原子層沉積實驗裝置的初步設計方案。
3)以Al<,3>O<,4>尖晶石晶體結構為基礎,構建仿真二維單元模型,通過分析不同沉積階段的反應機理,採用基於晶體結構的動力學蒙特卡羅方法(KLMC)對H-si(100)表面上沉積Al<,2>O<,3>的ALD過程進行模擬,建立了前驅體到達、表面化學反應、表面解吸三種不同的事件模型,通過時間管理實現ALD過程中氣體脈衝的交替循環。
4)在討論相關數據結構和算法後,利用C++語言編制仿真軟體,結合資料庫和OpenGL技術,實現數據的存儲與結果顯示。
5)改變工藝條件進行多組仿真實驗,結果表明薄膜的粗糙度受前驅體溫度、反應室真空度、基片溫度等多種因素的影響。其中基片溫度對初始沉積時間和生長速率的影響最為顯著。在溫度視窗內,基片溫度越低,薄膜生長越緩慢,初始沉積時間越長,表面粗糙度增加;隨著基片溫度的升高,初始沉積過程越短暫,薄膜很快封閉,溫度越高,生長速率越趨近於1ML/cycle(單分子層/循環),表面粗糙度也越小。將仿真結果與文獻中報導的結果相比較,兩者吻合較好。同時也進一步證實了ALD薄膜生長過程中兩個階段的存在。最後分析該模型存在偏差的原因,為ALD的套用研究提供一個理論基礎。
套用
原子層沉積技術由於其沉積參數的高度可控型(厚度、成份和結構),優異的沉積均勻性和一致性使得其在微納電子和納米材料等領域具有廣泛的套用潛力。就目前已發表的相關論文和報告可預知,該技術可能套用的主要領域包括:
原子層沉積(Atomic Layer Deposition,ALD),最初稱為原子層外延(Atomic Layer Epitaxy,ALE),也稱為原子層化學氣相沉積(Atomic Layer Chemical Vapor Deposition,ALCVD)。原子層沉積是在一個加熱反應器中的襯底上連續引入至少兩種氣相前驅體物種,化學吸附的過程直至表面飽和時就自動終止,適當的過程溫度阻礙了分子在表面的物理吸附。
目前可以沉積的材料包括: 氧化物,氮化物,氟化物,金屬,碳化物,複合結構,硫化物,納米薄層等。
半導體領域
電晶體柵極電介質層(高k材料),光電元件的塗層,電晶體中的擴散勢壘層和互聯勢壘層(阻止摻雜劑的遷移),有機發光顯示器的反濕塗層和薄膜電致發光(TFEL)元件,積體電路中的互連種子層,DRAM和MRAM中的電介質層,積體電路中嵌入電容器的電介質層,電磁記錄頭的塗層,積體電路中金屬-絕緣層-金屬(MIM)電容器塗層。
納米技術領域
中空納米管,隧道勢壘層,光電電池性能的提高,納米孔道尺寸的控制,高高寬比納米圖形,微機電系統(MEMS)的反靜態阻力塗層和憎水塗層的種子層,納米晶體,ZnSe塗層,納米結構,中空納米碗,存儲矽量子點塗層,納米顆粒的塗層,納米孔內部的塗層,納米線的塗層。
上述領域並不代表原子層沉積技術的所有可能套用領域,隨著科技的發展在不遠的將來將會發現其越來越多的套用。根據該技術的反應原理特徵,各類不同的材料都可以沉積出來。已經沉積的材料包括金屬、氧化物、碳(氮、硫、矽)化物、各類半導體材料和超導材料等。

